主要负责晶圆的加工制造,后道工艺在封测厂中进行,主要负责芯片的封装测试,其中,化学机械抛光(CMP)是实现晶圆全局平坦化的关键工艺,指的是通过化学腐蚀与机械研磨的协同配合作用,实现晶圆表面多余材料的高效去除与全局纳米级平坦化,是先进集成电路制造前道工序、先进封装等环节必需的关键制程工艺。
在前道加工领域:CMP 主要负责对晶圆表面实现平坦化。晶圆制造前道加工环节主要包括7个相互独立的工艺流程:光刻、刻蚀、薄膜生长、扩散、离子注入、化学机械抛光、金属化 CMP 则主要用于衔接不同薄膜工艺,其中根据工艺段来分可以分为前段制程(FEOL)和后段制程(BEOL),前段制程工艺主要为 STI-CMP 和 Poly-CMP,后段制程工艺主要为介质层 ILD-CMP、IMD-CMP 以及金属层 W-CMP、Cu-CMP 等。
在后道封装领域:CMP 工艺也逐渐被用于先进封装环节的抛光,如硅通孔(TSV)技术、扇出(Fan-Out)技术、2.5D 转接板(interposer)、3D IC 等封装技术中对引线尺寸要求更小更细,因此会引入刻蚀、光刻等工艺,而 CMP 作为每道工艺间的抛光工序,也得以广泛应用于先进封装中。
如果晶圆制造过程中无法做到纳米级全局平坦化,既无法重复进行光刻、刻蚀、薄膜和掺杂等关键工艺,也无法将制程节点缩小至纳米级的先进领域。随着超大规模集成电路制造的线宽不断细小化,制造工艺不断向先进制程节点发展,平坦化的精度要求也不断提高,CMP 步骤也会不断增加,从而大幅刺激了集成电路制造商对 CMP 设备的采购和升级需求。
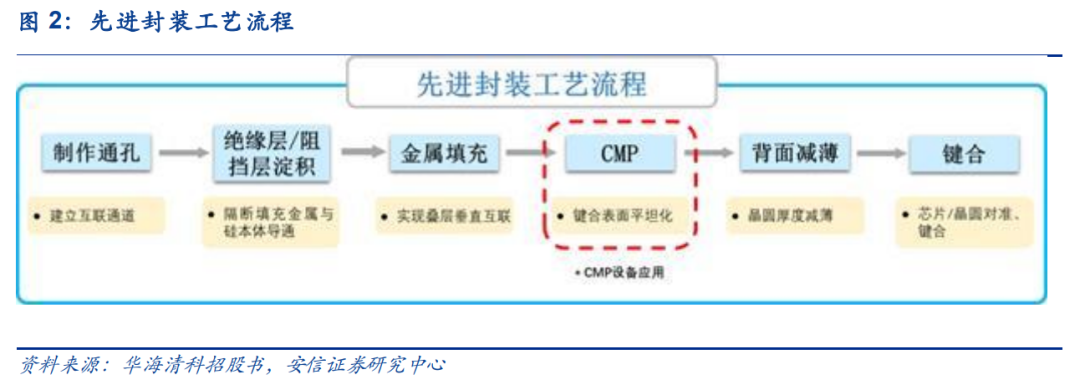
CMP(化学机械抛光)相较于传统方法有更高的加工精度和加工速度。传统的机械抛光和化学抛光方法,去除速率、抛光质量均无法满足先进芯片量产需求。而 CMP 技术利用磨损中的“软磨硬”原理,即用较软的材料来进行抛光以实现高质量的表面抛光,避免了由单纯机械抛光造成的表面损伤和由单纯化学抛光易造成的抛光速度慢、表面平整度和抛光一致性差等缺点,是目前唯一能兼顾表面全局和局部平坦化的抛光技术,在先进集成电路制造中被广泛应用。


CMP 设备主要依托 CMP 技术的化学-机械动态耦合作用原理,通过化学腐蚀与机械研磨的协同配合作用,实现晶圆表面多余材料的高效去除与全局纳米级平坦化(全局平整落差5nm以内的超高平整度)。CMP 抛光过程可以分为化学过程和物理过程。化学过程指:研磨液中化学成分与硅片表面材料产生化学反应,通过将不溶物转化为易溶物或软化高硬度物质,生成比较容易去除的物质。物理过程指:研磨液中的磨粒与硅片表面材料发生机械物理摩擦,从硅片表面去除这些化学反应物,溶入流动的液体中带走。
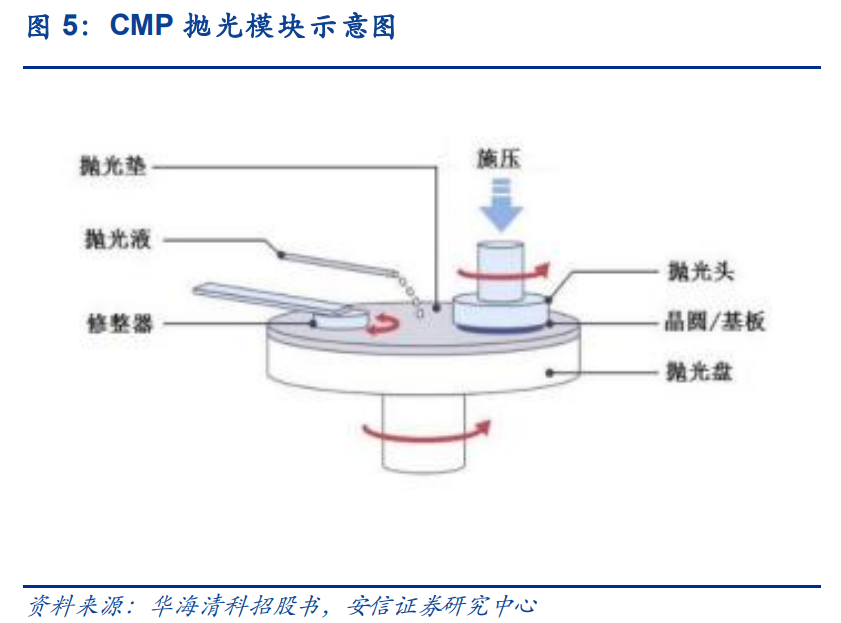

第二步:旋转的抛光头以一定压力压在旋转的抛光垫上,在硅片表面和抛光垫之间加入流动的研磨液(由亚微米或纳米磨粒和化学溶液组成),研磨液在抛光垫的传输和离心力的作用下均匀涂布,在硅片和抛光垫之间形成一层液体薄膜;
►缺陷量:CMP 工艺造成的硅片表面缺陷,一般包括擦伤、凹陷、侵蚀、残留物和颗粒污染,直接影响成品率。

2. CMP 抛光液:是研磨材料和化学添加剂的混合物,可使晶圆表面产生一层氧化膜,再由抛光液中的磨粒去除,达到抛光的目的。
3. CMP 钻石碟:是 CMP 工艺中必不可少的耗材,用于维持抛光垫表面一定的粗糙状态,通常与 CMP 抛光垫配套使用。
4. CMP 清洗液:主要用于去除残留在晶圆表面的微尘颗粒、有机物、无机物、金属离子、氧化物等杂质,满足集成电路制造对清洁度的极高要求,对晶圆生产的良率起到了重要的作用。
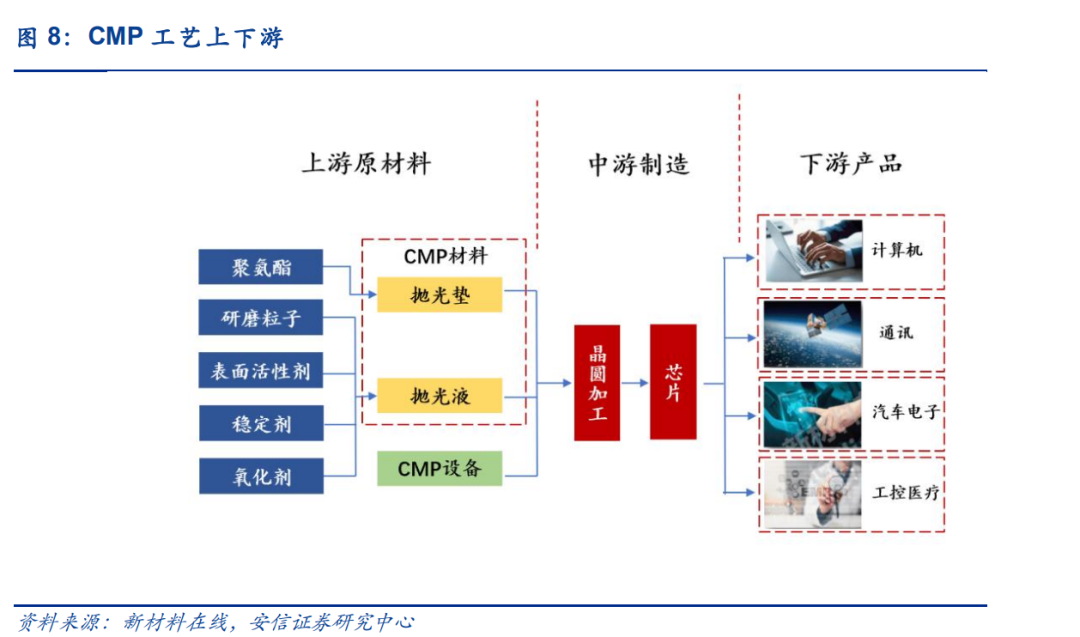
CMP设备是 CMP 技术应用的载体,集摩擦学、表/界面力学、分子动力学、精密制造、化学化工、智能控制等多领城最先进技术于一体,是集成电路制造设备中较为复杂和研制难度较大的设备之一。同时,由于铜连线在微处理器生产中广泛引用,因此唯一能够抛光铜金属层的 CMP 设备更成为芯片制造厂商必需的重要工具。
•抛光头:通常具有真空吸附装臵用于吸附晶圆,防止晶圆在抛光过程中产生位移,同时向下施加压力。
•研磨盘:起到对晶圆的支撑作用,承载抛光垫并带动其转动并对抛光头压力大小、转动 速度、开关动作等进行控制。
•清洗刷:用于 CMP 后清洗环节,在CMP后去除颗粒和其他化学污染物,分为清洁— 冲洗—干燥环节,保证晶圆干进干出。
•终点检测设备:终点检测设备用于检测 CMP 工艺是否把材料磨到正确的厚度,避免过薄(未起到抛光作用)及过厚(损失下层材料)带来的负面影响,通常使用电性能及光学两种测量方式。
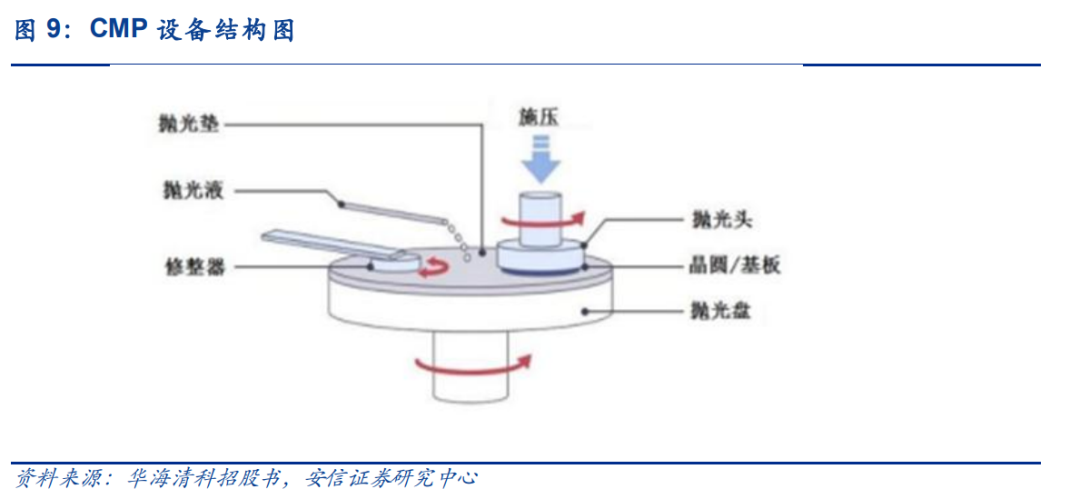
90~65nm 节点:随着铜互连技术和低 k 介质(一种绝缘材料)的广泛采用,浅槽隔离(STI)、 绝缘膜、铜互连层是 CMP 的主要研磨对象。
28nm 节点:逻辑器件的晶体管中引入高 k 金属栅结构(HKMG),因而同时引入了两个关键的平坦化应用,包括虚拟栅开口 CMP 工艺和替代金属栅 CMP 工艺。32nm 及 22nm 节点:铜互连低 k 介质集成的 CMP 工艺技术支持 32nm 和 22nm 器件的量产,其中开始出现的 FinFET 晶体管添加了虚拟栅平坦化工艺,这是实现后续 3D 结构刻蚀 的关键技术。

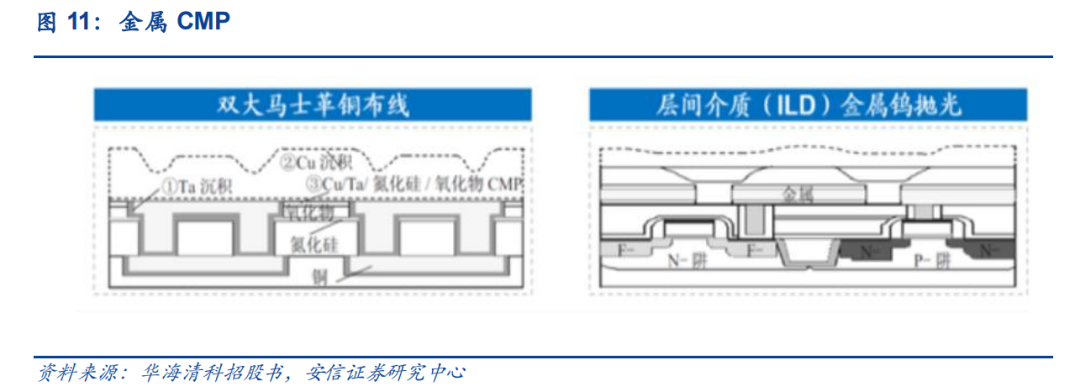
尽管受到疫情的影响,全球半导体市场规模依然同比增长 6.8%,达到了 4404 亿美元,预计 2021 年、2022 年全球半导体市场规模分别为 5530 亿美元、6015 亿美元,同比分别增长25.6%、8.8%。从分地区来看,2021 年和 2022 年亚太市场规模增速将高于全球平均,分别为 26.7%、8.4%,在全球市场的占比分别为 62.11%、61.90%。
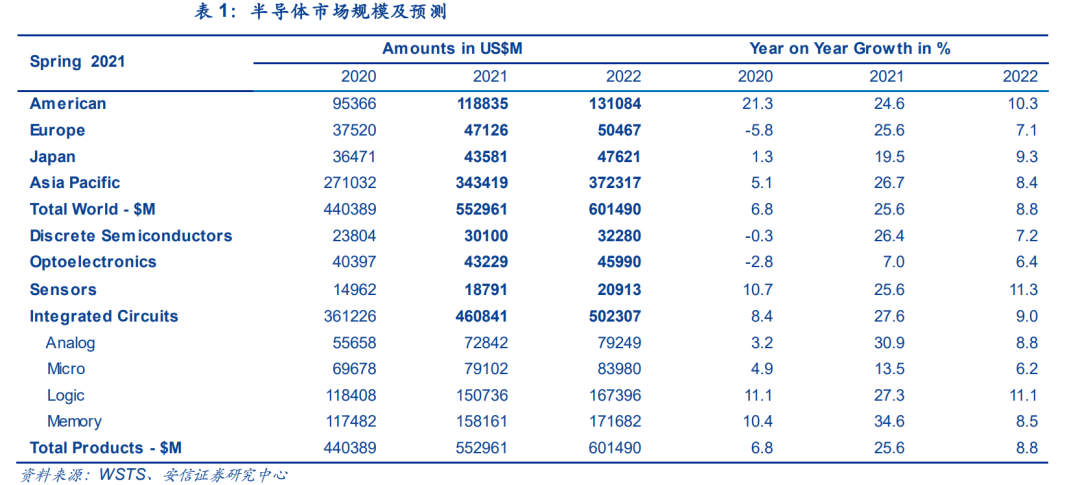
年复合增长率高达 27.70%,远超全球市场增速。从中国市场占比来看,中国半导体设备销售额在全球占比从 2013 年的 10.40%提高到 2020 年的 26.25%。

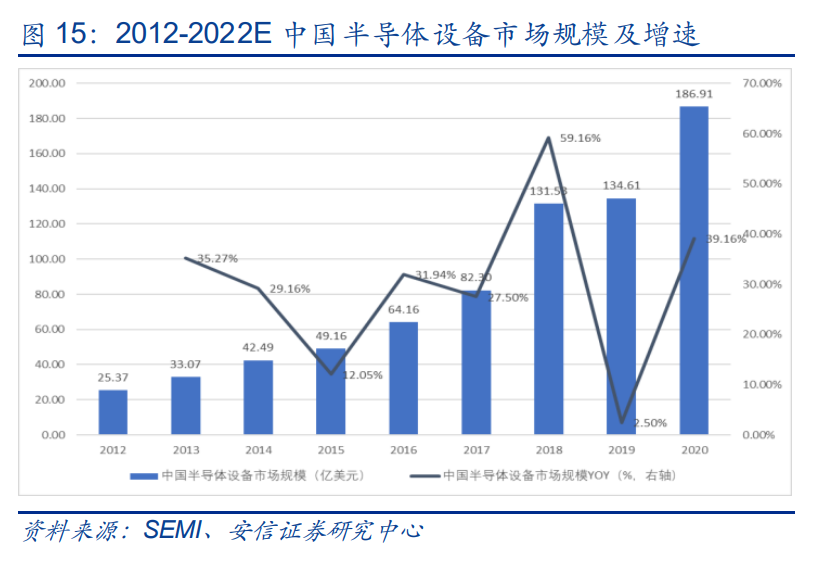
2020-2021 年全球晶圆制造设备市场规模 612 亿美元、880 亿美元,按照 3%的比例测算,CMP 设备对应市场规模为 18.4 亿美元、26.4 亿美元。

学、材料化学、精细加工、控制软件等多领域最先进技术于一体的设备,需保持精密的机械控制与干湿化学和机械间的平衡,具有较为复杂的研制难度,对技术、工艺、专利等有严格的要求,厂商竞争存在较高的技术壁垒。
后清洗专利申请量却处于下滑状态。全球 CMP 专利申请量总体保持平稳,反映了当前全球CMP 技术未存在重大技术革新,后来者要想追赶必须直面强大的专利壁垒。
呈日美企业垄断的格局。国内企业进入时间相对较晚,因此整体国产化率偏低。在 14nm以下最先进制程工艺的大生产线上所应用 CMP 设备仅由美国应用材料和日本荏原两家国际巨头提供。根据 Gartner 研究数据,2019 年美国应用材料和日本荏原的 CMP 设备销售额分别为 10.43 亿美元、3.725 亿美元,各占 70%、25%的全球市场份额。2017、2018、2019 三年,两家公司合计占有的市场份额分别为 98%、90%、95%,CMP 设备市场呈现出高度垄断的竞争格局。

显示器、自动化软件、卷对卷真空镀膜等多个领域。在半导体设备业务版块,公司制定了PPACt 战略旨在通过并行而非串行的创新来推动芯片的能效、性能、面积、成本和上市时间革新。公司产品覆盖沉积、刻蚀、掺杂、CMP 多工艺环节。
球市场份额分别达到了 17%、43%、64%、55%和 12%。2020 年公司总体收入 172 亿美元,半导体装备销售收入合计 113.67 亿美元,同比增长 26%,其中 CMP 设备销售收入11.33 亿美。





